半導体の樹脂バリ取り
加工内容
- 取る
樹脂表面にダメージを与えず、緻密なバリを除去。
数µmの緻密な研磨材を使用する、ウェットブラストによるバリ除去は、パッケージ破損や内部チップ剥離がない、ダメージレスな処理を可能にします。また、高いコントロール性が特長で、安定した品質の処理を比較的安価なコストで実現できます。
ウェットブラストによる精密樹脂バリ取り(デフラッシュ)

エポキシ樹脂などの熱硬化性樹脂を使用して、パワーデバイスなどの半導体パッケージをモールドする際に発生したバリを、ダメージレスで除去し、めっき前処理をおこなう表面処理技術です。
バリの種類
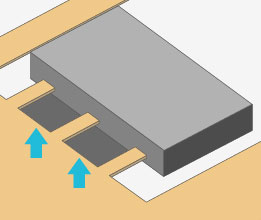
ダムバリ
リードの間を完全に埋めるバリ
従来のバリ取り工法で除去可能
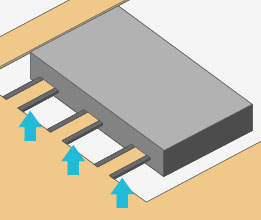
サイドバリ
リードフレームの脇に出る厚いバリ
従来のバリ取り工法で除去可能
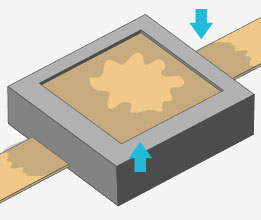
フラッシュバリ
リードフレームやヒートシンク上の薄バリ
パッケージの小型化、薄型化が進み、樹脂バリ取り(デフラッシュ)のニーズが増えている。安価で安定したバリ取りが必要
処理のポイント
- 安定した品質のバリ取りが安価で行える
- パッケージ破損や内部チップ剥離がない
- パッケージの表面を荒らさない
樹脂バリ取りの問題点
- ケミカル処理(電解前処理+ウォータージェット)を止めたい
- 半導体パッケージの内部破損、リードフレームと封止樹脂の界面剥離が発生する
- パッケージが小型でバリが除去しづらい
- 樹脂表面を削りすぎてしまう
- バリ取り後のめっき密着性が低い
ウェットブラストによる樹脂バリ取りの強み
- 電解前処理などのケミカルを使用しない
- バリの種類に合った粒子を使用することで、高速処理可能
- リード部など,狙った箇所のみ処理可能
- 圧力制御が容易
- 微細な粒子が使用可能
- 粉塵が発生しない
ウェットブラスト処理の特長
精密物理洗浄により、電極面のフラッシュバリを確実に除去できる
微細粒子と水が高速で衝突するエネルギーを利用し、汚れや異物を物体表面ごと削り取ることが可能です。
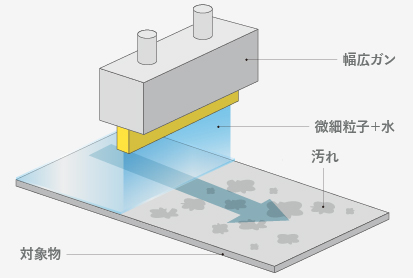
独自開発の幅広ガンを使用することによる、処理ムラの減少
従来のガン
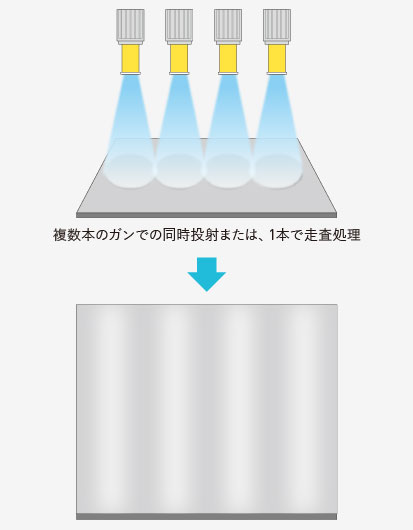
処理ムラが発生
幅広ガン(当社特許技術)

処理面全面を均一に処理可能
遊離砥粒加工によるソフトな処理により、パッケージへのダメージを抑えた処理が可能
ウェットブラストでは、微細粒子と水、圧縮空気が、加工対象物に対して霧状に噴射されます。そのため、加工対象物表面への加工は連続したパルス状のものとなり、その際加わる圧力は極めて小さく済みます。

微細粒子による低圧処理により、パッケージ表面に対してダメージを抑えた処理が可能
F=Mα
(加工力)=(粒子の質量)✕(衝突の加速度)
※粒子の速度が同じ場合、粒子径が1/10の時、加工力は1/1000となる

樹脂バリ取り(デフラッシュ)例
リードフレームの強固なバリ除去

処理前

ウェットブラスト処理後
ヒートシンク面のフラッシュバリ除去

処理前

ウェットブラスト処理後
ダムバリ、サイドバリの除去

処理前

ウェットブラスト処理後
ダムバリの除去

処理前

ウェットブラスト処理後
装置例
ワークサイズや処理内容に合わせて、以下の装置をご提案します。
しかし本来、当社の装置は、用途と条件を御社工程に最適化する、自由設計が基本となります。全てのお客様に、最適な仕様をご提供するのが当社の基本方針です。
まずはワークの素材やサイズ、処理目的、設備条件などをご相談ください。当社専門担当がご対応させていただきます。
板状ワーク向け装置
- 自動機
板状ワークを処理する小型自動装置です。PFEの小型ローコスト版となります。半導体やセラミックス板、Cu板、フィルム等の処理に向いています。ワークサイズに合わせた2種類をラインナップしています。
研究開発向け装置
- 半自動機
幅広ガンによる均一な処理表面を実現する、実験室にも導入しやすい小型装置です。ブラスト投射やガンの動作は手軽に設定可能です。研磨材の選定次第でさまざまな表面が形成でき、味見テストや条件出しに最適です。