アンダーフィルの濡れ性改善
加工内容
- 粗す
ウェットブラストによる濡れ性改善
ワイヤボンディングに比べICパッケージを小型化可能なフリップチップパッケージの回路表面に、ウェットブラストにより微細に表面を粗化することで、アンダーフィル(ICチップの金線を保護する液状硬化性樹脂)による封止の充填性を高めます。
処理のポイント
- ピンニング効果により、アンダーフィルの濡れ性・保持性を高めブリードを防止できる。
- 物理的に表面の形状を変化させるため、表面改質効果に時間依存性がない。
- ソルダーレジスト上の異物・汚れ除去を行い、表面の完全洗浄が可能。
問題点
- 表面改質効果に時間依存性がある。 =濡れ性のコントロールが困難
- アンダーフィルの充填性・流動性が悪く、上手に濡れ広がらない。もしくはブリードアウト(不要な部分へのはみ出し)が起こる。
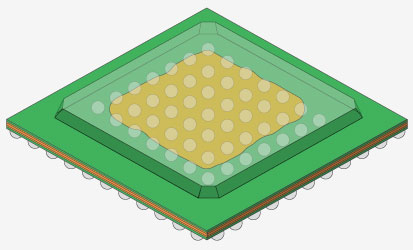
濡れ広がらない
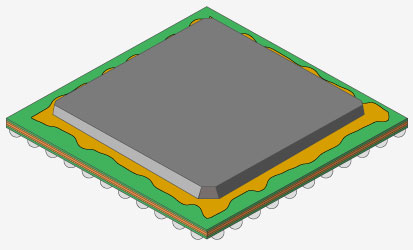
ブリードアウトする
処理のイメージ
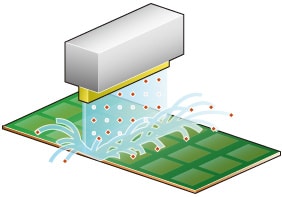
- SR表面上の異物の除去、洗浄
- 表面積拡大による濡れ性向上
- ピンニングによるブリード防止